광조사에 기반한 효과적인 용해도 조절을 위한기능성 고분자의 정교한 구조 설계 및 구현(2025년 12월호)
- 2025년 12월 4일
- 7분 분량
최종 수정일: 2025년 12월 15일

윤상민, 박주영, 이다혜, 도수희, 김명웅* | 인하대학교 화학과 교수, mkim233@inha.ac.kr
서 론
특정 용매에 대한 고분자의 용해도를 이해하고 조절하는 것은 고분자를 활용하는 모든 분야에서 가장 기초적인 기술이며, 광리소그래피(photolithography)와 같은 특정 분 야에서는 핵심적인 원리이다. 일반적으로 두 가지 방법론 이 활용되고 있다. 첫 번째는 고분자가 지닌 기능기를 화학적으로 변화시켜 특정 용매에 대한 용해도를 증가시키거나 감소시키는 것이다. 대표적인 예시로 특정 기능기에 대한 탈보호화 반응을 통한 고분자의 전체적인 극성 변화이다. 두 번째로는 고분자의 분자량을 조절하는 것이다. 고분자 사슬의 분해 반응을 통하여 용해도를 증가시키거나,[참고문헌 1] 반대로, 분자량을 증가시켜 용해도를 감소시킬 수 있다. 이는 고 분자 분해를 통한 화학적 재활용에서, 혹은 화학적 환경에 대한 내성을 향상시키기 위한 화학적 기능성을 지닌 가교 고분자 네트워크에서 찾을 수 있다.[참고문헌 2, 3] 더 나아가 외부 자극 을 통해 용해도를 조절함으로써, 다양한 응용 분야에서 요구되는 형태학적 구조를 구현하기 위하여 필요한 제어에 대 한 가능성이 지금까지 활발히 연구되어 왔다. 대표적인 예로, 박막 형태의 포토이미징 소재가 있으며, 이는 광리소그래피를 통한 패턴 형성에서 핵심적인 역할을 하며, 반도체 소자,[참고문헌 4] 센서, [참고문헌 5] 디스플레이 소자[참고문헌 6] 등 현대 전자기기에서 활용 되는 다양한 마이크로 및 나노 구조체의 제조에 필수적이다. 이러한 용해도 조절에 크게 영향을 미치는 인자는 고분자의 측쇄기와 주쇄의 구조적 변화이며, 이에 따른 용해 거동 연구를 통해 구조-성질 상관관계를 이해하는 것은 고분자 기반 소재 설계에 필수적이다. 본 논문에서는 광조사에 기반한 효과적인 용해도 조절을 가능하게 하기 위한 기능성 고분자의 구조 설계 및 구현 전략, 그리고 고분자의 화학 구조와 거시적인 용해 거동 사이 상관관계를 이해하기 위한 노력을 소개하고자 한다.
본 론
1. 용해도 조절을 위한 단량체 구조 변화
화학 증폭형 레지스트(chemically amplified resist; CAR)의 주요 구성 요소인 공중합체의 화학적 구조는 KrF 엑시머 레이저(248 nm), ArF 엑시머 레이저(193 nm) 및 EUV (13.5 nm)를 포함한 다양한 광원에서 광조사에 의한 용해도 조절 메커니즘이 작동될 수 있도록 진화되어 왔다. CAR 시스템은 KrF 및 ArF 엑시머 레이저를 사용하는 리소 그래피 기술에 최적화되어 왔으나, EUV 리소그래피에서는 여전히 해결되어야 할 중요한 과제가 남아 있다. 해상도 (resolution), 선폭 거칠기(line edge roughness; LER), 그 리고 감도(sensitivity) 사이의 상충 관계(trade-off), 이른 바 RLS trade-off 문제이다.[참고문헌 7, 8] 이 문제를 해결하기 위해 다 양한 화학적 접근이 제안되었지만, CAR 시스템은 기존 반도체 소자 제조 공정과의 높은 호환성 덕분에 여전히 EUV 리소그래피용 소재의 유력한 후보로 남아 있다.[참고문헌 9, 10]
일반적인 CAR 시스템에서 자외선은 광산발생제(pho-toacid generator; PAG)를 활성화하여 강산 분자를 생성하여 고분자 내의 비극성 보호기를 탈보호화 하여 극성기 를 형성, 염기성 수용액(e.g. tetramethyl ammonium hydroxide; TMAH)에 용해된다. 이러한 메커니즘은 양각 현상(positive-tone development; PTD)을 가능하게 하며, 이는 DUV 및 EUV 리소그래피에서 표준으로 사용된다. 그러나 패턴 크기가 고분자 사슬의 길이에 근접하는 고해상도 영역에서는 수용액을 이용한 현상 시 현상되지 않은 고 분자 사슬이 응집된 구조와 유사한 형태가 되어 패터닝 성능, 특히 LER 측면에서 문제를 일으킬 수 있다.[참고문헌 11, 12] 이러한 문제는 첨가제가 없는 유기용매(e.g. n -butyl acetate; nBA)를 현상액으로 사용, 형성된 극성 작용기가 nBA에서는 고분자 사슬을 불용성으로 만들어, 음각 현상(negative-tone development, NTD) 시스템을 구현할 수 있다.

NTD 시스템을 실제 반도체 제조 공정에 적용하기 위해서는, CAR 시스템에서 고분자의 구조적 변수와 여러 주요 물리화학적 특성 간의 상관관계를 명확히 규명하는 것이 중요하다. 전통적인 공중합체의 물리화학적 성질 조절 방법은 단위체의 구조를 바꾸는 것이다. 모델 삼공중합체를 선정한 뒤, 두 개의 단위체는 고정시키고 세 번째 단위체의 구조를 변화시킨다. 고정되는 단위체로는 4-하이드록시스타 이렌(4-hydroxystyrene, HOST),[참고문헌 13, 14] 두 번째 단위체로는 ArF 및 EUV 리소그래피에서 2-에틸-2-메타크릴옥시아다 만탄(2-ethyl-2-methacryloxyadamantane, EAMA)을 선택하였다. HOST는 건식각 내성과 기판에 대한 접착성을 부여하며, EAMA는 PAG에서 생성된 산이 촉매로 작용하는 탈보호화 반응을 통해 극성의 메타크릴산(methacrylic acid)으로 전환되어 고분자 사슬의 극성을 조절한다.[참고문헌 15] 세 번째 메타크릴레이트 단위체는 nBA 내에서의 용해도 조절 역할을 하며, 측쇄기를 방향족, 지방족 락톤, 그리고 락톤 고리 구조로 체계적으로 변화시켰다 [그림 1a].[참고문헌 16, 17] 또한 분 자량 및 분자량 분포, 조성(composition) 역시 함께 조절 하였다. 이와 같은 구조적 매개변수의 제어를 통해, CAR재료의 광패턴 형성에서 핵심적인 특성 중 하나인 얇은 막 상태에서의 공중합체 용해 거동(dissolution behavior)을 탐색하였다[그림 1b]. 그 결과, 산 발생 후 극성이 전환된 공중합체가 보이는 용해 거동 변화는 세 번째 단위체의 측쇄기의 구조가 락톤 고리 구조 및 락톤 고리를 포함한 지방 족 고리 구조를 가질 때 가장 효과적이었으며, 고리 구조의 방향성이 증가할수록 제어가 어려워지는 것을 확인하였다. 더 나아가 공단량체 단위의 구조, 공중합체의 조성, 고분자의 분자량과 분산도가 용해 거동에 종합적인 영향을 보이는 것으로 확인되어, 이러한 모든 구성요소 간의 균형을 찾는 것이 중요함을 강조하였다.
2. 공중합체를 구성하는 단위체의 이성질체 효과에 따른 용해도 조절
박막 상태의 고분자 물리화학적 특성은 고분자 사슬 내의 화학단위에 의해 지배된다. 그러나 이러한 특성을 조절하는 것뿐만 아니라, 고분자는 의도된 응용 목적에 맞는 특정 화학적 역할도 수행해야 한다. 포토패터닝 소재의 경우, 광 혹은 광에 의하여 발생한 산에 의해 화학적 구조가 변화하여 고분자 사슬 전체의 극성이 급격히 변화되어야 하며, 성공적인 패턴 전사를 위한 접착력과 식각 공정에 대한 저항성을 지녀야 한다. 상기한 대로, 이러한 기능들은 적절한 화학적 작용기를 지닌 공단량체를 이용한 기능성 공중합체의 분자 설계 및 합성을 통해 부여될 수 있다. 이를 위해 기존에 활용되어온 기능성 단위들은 광범위하 게 연구되어 왔으며, 산업 공정에서 높은 효율성과 호환성이 입증되어 있다. 그 대표적인 예가 HOST 단위체이다.[참고문헌 15] HOST는 높은 극성으로 인해 접착력과 다양한 용매 분자 와의 상호작용이 향상되며, 카보네이트 또는 아세탈기를 도입함으로써 광에 의해 매개되는 극성 조절이 가능하고, 방향족 구조에 기인한 우수한 식각저항성을 부여하여 전통적으로 공중합체에 포함되어 왔다. 그러나 이러한 전통적 구조의 안정성과 공정 호환성은 특정 특성을 향상시킬 수 있는 대체 화학 기능기의 탐색을 제한한다. 새로운 기능기를 도입하면 일부 특성은 향상되더라도, 다른 특성이나 공정성이 저하될 수 있기 때문이다.
최근 연구에서는 HOST의 장점을 유지하면서도 최소한의 구조적 변화를 통해 물리화학적 특성을 조절하는 방법을 보고하였다.[참고문헌 18] 이 문제를 해결하기 위하여 HOST 단위의 페놀성 OH의 위치를 para 위치에서 meta 및 ortho 위치로 옮겨 물리화학적 성질을 조절하는 이성질체 효과를 활용하였다. 이는 HOST의 주요 기능을 유지하면서도, CAR 시스템 내에서 용해 거동 및 산 확산과 같은 핵심 물리화학적 특성을 조절할 수 있게 한다[그림 1a]. 이를 위하여 HOST, EAMA, 용해도 거동 조절에 유리한 락톤 고리를 포함한 지방족 고리를 지닌 메타크릴레이트(2-oxo-hexahydro-2H-3,5-methanocyclopenta[b]furan-6-yl methacrylate; OMF) 삼공중합체를 기본 구조로 하며, 분자량과 조성이 일정하면서 HOST의 페놀성 OH의 위치가 변화된 공중합체를 구현하였다. 일반적으로, 주쇄 근처에 위치한 페놀성 OH는 사슬 간 수소 결합이나 주변 용매 분자와의 상호작용이 제한되기 때문에, 상대적으로 사슬 운동성과 소분자와의 상호작용이 자유로워 최소한의 구조 변화로 광조사 기반 용해 거동 조절이 효과적으로 가능함 을 보였다[그림 1c].
3. 용해 거동의 정량적 이해를 통한 구조-성질 상관관계 탐색
용해 거동 연구는 나아가 Hansen 용해도 파라미터 (Hansen solubility parameter; HSP) 측정을 통하여 공중합체의 구조 변화에 따른 용해 거동의 정량적 이해로 확장되었다. HSP는 세 가지의 파라미터, 즉 고분자 사슬과 용매 분자 사이의 분산 상호작용(dispersive interaction, δD), 극성 상호작용(polar interaction, δP), 수소 결합(hydrogen bonding, δH)이 포함된 δ 2 = δ 2 + δ 2 + δH2의 식으로 나타내어진다.[참고문헌 19] 이 파라미터들은 공중합체를 여러 용매에 용해시켜 용해 여부를 판단하여 얻어낼 수 있다. 세 번째 단위체의 구조 변화에 따라 HSP가 체계적으로 변화되는 것이 확인되었으며, 더 나아가 산으로 처리되어 극성이 크게 변화되면 HSP 또한 용매의 HSP에서 멀리 떨어지게 되면서 그 거리(Ra)를 통하여 용해도 변화 를 정량적으로 표현할 수 있었다[그림 2a].[참고문헌 16] 용해 속도 측정 결과와 결합하여 분석한 결과, 용해 영역의 경계가 HSP 공간 상 어디에 위치하는지 결정할 수 있었으며, 이 는 CAR 시스템에 응용이 가능한 공중합체 결정을 위한 기반으로 작동할 수 있음을 보였다.

HOST의 이성질체 효과가 HSP에 미치는 영향은 매우 뚜렷하여 OH기가 공중합체 주사슬로부터 멀리 떨어질수록 수소 결합이 더 효과적으로 작용하며, 반대로, 페놀기가 방향족 고리의 ortho 위치에 존재할 경우, 입체 장애로 인해 효과적인 수소 결합이 저해되어 공중합체의 총 HSP (δT)에 대한 이성질체 효과는 주로 수소 결합 성분 (δH)에 의해 지배됨이 확인되었다[그림 2b].[참고문헌 18] 주목할 점은, para 위치에 OH가 있는 HOST가 포함된 공중합체가 가장 높은 Ra 값을 나타낸 반면 ortho 위치에 OH가 있 는 HOST가 포함된 공중합체가 가장 낮은 Ra 값을 보여 용해 속도 실험에서 관찰된 경향과 동일한 패턴을 나타내 었으며, 용해 속도는 Ra 값과 선형적으로 비례함을 확인 하였다[그림 2c]. 이 결과는 HSP 값이 박막 상태에서 고 분자의 용해 거동과 매우 높은 상관성을 가진다는 것을 강 하게 시사하며, 더 나아가 HSP에 기반한 용해 거동 연구는 목표 고분자의 용해 특성을 예측하는 데에도 활용될 수 있으며, 고분자의 구조-성질 상관관계 이해의 중요성을 강조하고 있다.
4. 정량화된 용해 거동 이해에 기반한 포토패터닝 수치 모사
CAR 메커니즘 기반 포토패터닝의 가능성을 예측하기 위한 방법으로, 고분자 사슬을 모사하기 위한 coarse-grained 모델의 활용이 효과적이라는 것이 보고되었다.[참고문헌 20] 이러한 수치 모사 접근법에서는 특정 용매 내에서 보호 혹은 탈보호된 공중합체 사슬 간 유효 상호작용 및 용해도를 Flory-Huggins 파라미터(Flory-Huggins parameter; χ)와 사슬의 길이(Ν)를 이용한다. 또한 보호된 기능기의 양과 유리 전이 온도(Tg) 또한 고려가 가능하다. 이를 통하여 사슬의 형태가 LER 형성에 어떤 영향을 미치는지 규명할 수 있었으며, 더 나아가 EUV 리소그래피 과정에서 일어나는 stochastic 효과 등의 다양한 이슈들을 모사하여 패터닝 결과를 예측하는 것이 가능함을 보였다[그림 3a].[참고문헌 21] HSP와 χ 파라미터의 상관성을 이용하여 상기한 공중합체와 nBA 사이 χ 파라미터를 수치 모사 접근법에 적용하였다.[참고문헌 16] [그림 3b]는 사슬 형태의 변화와 현상 과정에서 공중합체 사슬이 용해되어 제거되는 과정을 보여준다. 초기 공중합체 박막 상부에 위치한 노광되지 않은 레지스트를 우선적으로 용해시킨다. 노광된 영역은 대부분 유지되며, 용해 과정은 시스템 크기의 절반에 해당하는 임계 선폭에 도달할 때 종료됨을 확인할 수 있다. 더 나아가, 네 가지 서로 다른 세 번째 공단량체를 포함하는 4종의 공중 합체의 최종 패터닝 결과를 비교 분석하였으며, 세 번째 단위체의 변화에 따른 용해 거동 변화와 같은 경향성을 보 이는 것으로 확인되었다[그림 3b]. 따라서 패턴 형성 능력을 결정하는 핵심 요인은 공중합체의 용해도임을 명확하게 하며, 더 나아가 실험적으로 결정된 정량적 파라미터와 수치 모사 접근법의 결합으로 화학 구조의 변화에 따른 최종 패턴의 예측이 가능함을 확인하였다.
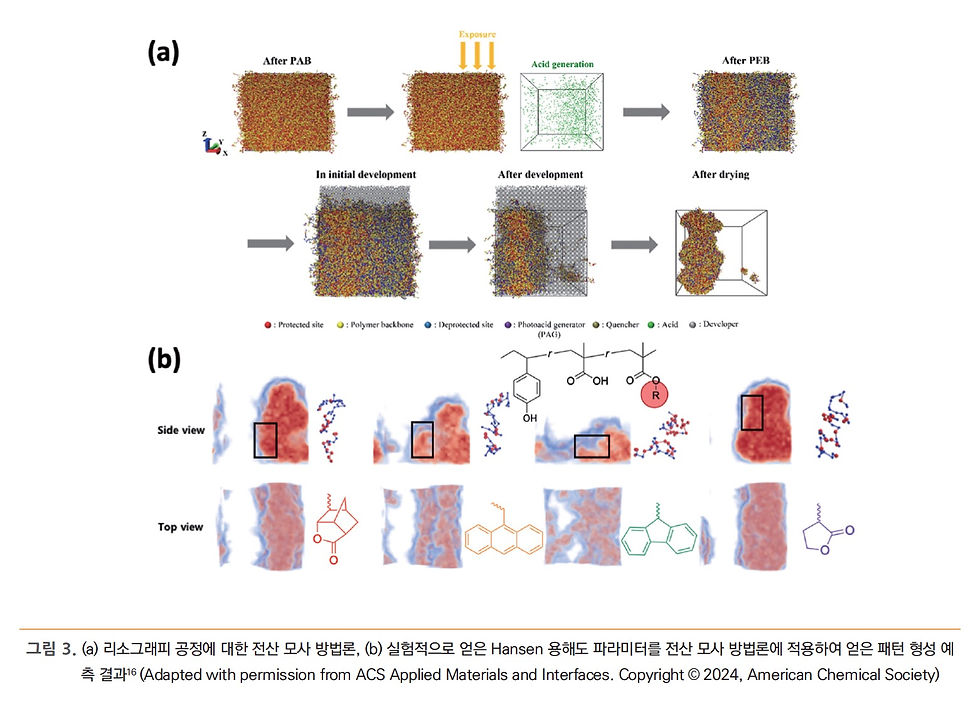
5. 고분자의 분자량 변화에 기반한 용해도 조절
지금까지 서술한 고분자 측쇄기의 화학적 변환에 기반한 메커니즘을 통한 용해도 조절뿐만 아니라, 고분자의 분자량 즉 사슬 길이를 변화시켜 용해도를 제어하는 방법론 또한 지속적으로 연구되어 왔다. 예를 들어, 두 개의 반응기를 지닌 에폭시 화합물을 양이온 중합하여 용해되지 않는 가교 고분자 네트워크를 형성할 수 있다.[참고문헌 22] 반대로, 광 반응에 의해 주사슬을 절단하여 고분자의 분자량이 감소 시키고, 이로 인해 용해도가 급격히 증가하여 광패터닝이 가능하게 할 수 있다.[참고문헌 7, 23] 이러한 두 가지 광조사 기반 용해 도 조절 전략, 즉 측쇄기 극성 전환과 사슬 분자량 감소는 별개로 적용되어 왔으며, 기존의 용해도 조절형 고분자는 주로 분자량 감소보다는 극성 변화에 의존한다. 비록 몇 몇 주사슬 절단형 고분자가 차세대 리소그래피 재료로서 잠재력을 보이고 있지만,[참고문헌 1, 13] 기존 소재의 구조에서 크게 벗어나기 때문에 지금까지 검증된 기존 소재의 기능기와 그에 따른 공정 호환성을 완전히 활용하지는 못한다. 따라서, 공중합체 내에서 광반응성 화학 변환 기능을 유지하면서 동시에 분자량 감소를 통한 광조사에 따른 용해도 변화의 극대화를 이루는 것은 난제로 여겨져 왔다. 이를 해결하기 위하여 광조사에 의하여 화학적 변화가 일어나는 측쇄 기능기를 지님과 동시에 주사슬 중앙에 광 분해성 기능기인 니트로벤질 에스터(nitrobenzyl ester) 작용기를 갖는 화학적 설계가 제안되었다[그림 4a].[참고문헌 24] 모델 시스템으로서 비화학 증폭형(non-CAR) 시스템인 과 불화옥틸 메타크릴레이트(perfluorooctyl methacry-late; PFOMA), 스피로피란 메타크릴레이트(spiropyran methacrylate; SPMA), 이소보닐메타크릴레이트(isobornyl methacrylate; IBMA)로 구성된 공중합체가 선정되었다. 이 공중합체는 플루오린이 공유결합되어 있는 물질과 일반 유기 물질 간의 화학적 비상용성에 기반 하여, OLED 소재와 같은 화학적으로 취약한 유기층을 패 터닝하기 위한 소재로 사용되어 왔다.[참고문헌 25] 스피로피란 작용 기는 광이성화 반응을 통하여 특정 과불화 용매와의 상호 작용을 증가시켜, 광조사 영역의 용해도를 증가시켜 패턴 형성을 가능하게 한다. 그러나 해당 공중합체의 광조사 기반 용해도 변화 정도와 감도가 충분히 크지 않아, 건식각을 통한 하부층으로의 패턴 전사에 필요한 충분한 패턴 단 차를 확보하기 어렵다는 한계가 있었다.

제안된 공중합체는 새로이 설계된 광분해성 니트로벤질 기능기를 포함하는 RAFT제[(reversible addition–frag-mentation chain transfer(RAFT) agent]로부터 상기한 공중합체의 단량체들을 RAFT 중합하여 구현되었다. 해당 공중합체는 광조사를 통하여 주쇄가 절단됨과 동시에 스피로피란 작용기의 광이성질화 반응으로 공중합체의 용해도를 현저히 증가시켜 충분한 단차의 패턴 형성이 가능해졌으며, 후공정인 패턴 전사 또한 용이해졌음을 확인하였다[그림 4b]. 더 나아가 주쇄 절단 반응의 효율을 더욱 높이기 위하여 니트로벤질 에스터 기능기의 흡광 거동을 향상시킬 수 있는 구조 설계 및 구현이 진행되었다[그림 4a]. 광패터닝 공정에 대한 감도가 증가함을 확인하였을 뿐만 아니라 고분자 사슬 내 니트로벤질에스터 작용 기의 광절단 반응의 화학적 원리를 이해할 수 있는 반응 속도론 연구가 진행되어 제안된 고분자 시스템을 깊이 이해할 수 있도록 하였다. 해당 공중합체는 OLED 소자에 사용되며, 화학적 침해성을 갖는 전자 수송층 상에서 패 턴을 형성하며, 해당 패턴을 이용한 건식각을 수행하여 성공적으로 패턴 전사를 진행하기 위한 소재로 활용이 가능 함이 확인되었다[그림 4c]. 이 결과는 제안된 화학 설계가 고유한 고분자 구조를 유지하면서도 패터닝 소재의 성능을 향상시킬 수 있는 잠재력을 지니고 있음을 명확히 보여 주었다.
결 론
광조사를 통하여 고분자의 용해도 조절 방법론은 고분자의 구조를 체계적이고 합리적으로 다변화함으로써 특정 응용 분야에 활용이 가능하다. 특히 공중합체를 이루는 단위 체의 측쇄 구조의 다변화와 단위체의 화학 구조에 대한 이 성질체 효과로 용해도 조절의 범위가 더욱 넓어질 수 있다. 또한 특정 응용 분야에서 활용되던 전통적인 화학 구조에서 크게 벗어나지 않은 소재 개발이 가능하기 때문에 기존에 사용되던 공정에 대한 호환성을 유지할 수 있다. 더 나아가 주쇄를 절단하는 기능기를 절단 후 구조가 예측 가능 하도록 설계하여 측쇄의 화학적 변화에 의한 효과에 주쇄 절단 효과를 더하여 용해도 조절 능력을 극대화하는 것이 가능하다. 이러한 연구에서 소홀히 하지 말아야 할 것은 화 학적 구조의 변화에 따른 용해 거동의 변화를 체계적이고 정량적으로 분석하고, 화학 구조에 대한 상관관계를 탐색하여 구조-성질 상관관계를 이해하는 것이다. 이에 대한 이해는 실험적인 결과를 이론적으로 확장하여 용해도 거동을 예측할 수 있는 모델을 만들 수 있을 것이다. 그리고 최근 주목을 받고 있는 머신러닝 및 딥러닝 기술로 확장하여 용해 성질을 예측할 수 있는 AI 기반 모델을 개척하는 것 또한 가능할 것이다. 다변화되어 가고 있는 고분자의 구 조적 파라미터 변화 연구를 주목하고 그 결과로부터 새로운 형태의 용해도 조절을 위한 화학적 플랫폼이 개발되어 여러 분야의 난제를 극복하기 위한 기반이 되기를 기대해 본다.
Deng, J.; Bailey, S.; Jiang, S.; Ober, C. K. Modular Synthesis of Phthalalde-hyde Derivatives Enabling Access to Photoacid Generator-Bound Self-Immolative Polymer Resists with Next-Generation Photolithographic Properties. J. Am. Chem. Soc. 2022, 144, 19508
Choi, S.; Yutzy, L. D.; Ko, Y. H.; Lee, J.-K.; Jung, J. P.; Kim, M. Photo-Crosslink-able Polymeric Coatings Providing Chemically Versatile Reactive Surfaces on Various Substrates. Chem. Mater. 2023, 35, 3592.
An, S.; Nam, J.; Kanimozhi, C.; Song, Y.; Kim, S.; Shin, N.; Gopalan, P.; Kim,
M. Photoimageable Organic Coating Bearing Cyclic Dithiocarbonate for a Multifunctional Surface. ACS Appl. Mater. Interfaces 2022, 14, 3274.
Liu, X.; Dai, S.; Zhao, W.; Zhang, J.; Guo, Z.; Wu, Y.; Xu, Y.; Sun, T.; Li, L.; Guo, P.; et al. All-Photolithography Fabrication of Ion-Gated Flexible Organic Transistor Array for Multimode Neuromorphic Computing. Adv. Mater. 2024, 36, 2312473.
Welch, M. E.; Ritzert, N. L.; Chen, H.; Smith, N. L.; Tague, M. E.; Xu, Y.; Baird, B. A.; Abruña, H. D.; Ober, C. K. Generalized Platform for Antibody De-tection using the Antibody Catalyzed Water Oxidation Pathway. J. Am.Chem. Soc. 2014, 136, 1879.
Krotkus, S.; Ventsch, F.; Kasemann, D.; Zakhidov, A. A.; Hofmann, S.; Leo, K.; Gather, M. C. Photo-patterning of Highly Efficient State-of-the-Art Phosphorescent OLEDs Using Orthogonal Hydrofluoroethers. Adv. Opt.Mater. 2014, 2, 1043.
Deng, J.; Bailey, S.; Ai, R.; Delmonico, A.; Denbeaux, G.; Jiang, S.; Ober, C. K. Synthesis of End-Cap Enabled Self-Immolative Photoresists For Ex-treme Ultraviolet Lithography. ACS Macro Lett. 2022, 11, 1049.
Brainard, R.; Higgins, C.; Hassanein, E.; Matyi, R.; Wüest, A. Film Quantum Yields of Ultrahigh PAG EUV Photoresists. J. Photopolym. Sci. Technol. 2008, 21, 457.
Furutani, H.; Shirakawa, M.; Nihashi, W.; Sakita, K.; Oka, H.; Fujita, M.; Omatsu, T.; Tsuchihashi, T.; Fujmaki, N.; Fujimori, T. Novel EUV Resist Materials for 7 nm Node and Beyond. J. Photopolym. Sci. Technol. 2018, 31, 201.
Ku, Y.; Kim, K.; Oh, H.-T.; Park, B.-G.; Lee, S.; Lee, J.-K.; Koh, C.; Nishi, T.;
Kim, H.-W. Extreme UV Resist Exhibiting Synergism Between Chemical and Physical Crosslinking Mechanisms. Langmuir 2023, 39, 3462.
Fujimori, T. Negative-Tone Imaging (NTI) for Advanced Lithography with EUV Exposure to Improve ‘Chemical Stochastic’. In 2021 China Semicon-ductor Technology International Conference (CSTIC), 14-15 March, 2021; IEEE: p 20895114.
Fujimori, T.; Tsuchihashi, T.; Itani, T. Recent Progress of Negative-Tone Imaging Process and Materials with EUV Exposure. J. Photopolym. Sci.Technol. 2015, 28, 485.
Ober, M. S.; Romer, D. R.; Etienne, J.; Thomas, P. J.; Jain, V.; Cameron, J. F.; Thackeray, J. W. Backbone Degradable Poly(aryl acetal) Photoresist Polymers: Synthesis, Acid Sensitivity, and Extreme Ultraviolet Lithogra-phy Performance. Macromolecules 2019, 52, 886.
Okamoto, K.; Ishida, T.; Yamamoto, H.; Kozawa, T.; Fujiyoshi, R.; Umegaki, K. Dynamics of Radical Cations of Poly(4-hydroxystyrene) in the Presence and Absence of Triphenylsulfonium Triflate as Deter-mined by Pulse Radiolysis of Its Highly Concentrated Solution. Chem. Phys. Lett. 2016, 657, 44.
Yeo, J.; Woo, J.; Choi, S.; Kwon, K.; Lee, J.-K.; Kim, M. Comprehensive Stud-ies of Continuous Flow Reversible Addition–Fragmentation Chain Transfer Copolymerization and its Application for Photoimaging Mate-rials. Polym. Chem. 2022, 13, 4535.
Ko, Y. H.; Lee, H.; Kim, H.; Kim, S.; Ahn, C.; Hur, S.-M.; Kwak, Y.; Kim, M. Chemical Structure–Physicochemical Property Relationships of Copoly-mers Utilizable for Negative-Tone Photoimaging via Chemical Amplifi-cation. ACS Appl. Mater. Interfaces 2024, 16, 15286.
Sohn, H.-S.; Cha, S.-H.; Lee, W.-K.; Kim, D.-G.; Yun, H.-J.; Kim, M.-S.; Kim, B.-D.; Kim, Y.-H.; Lee, J.-W.; Kim, J.-S. Synthesis of ArF Photoresist Poly-mer Composed of Three Methacrylate Monomers via Reversible Addi-tion-Fragmentation Chain Transfer (RAFT) Polymerization. Macromol. Res. 2011, 19, 722.
Lee, H.; Kim, S.; Ko, Y. H.; Park, J.; Lee, D.; Ku, Y.; Ahn, C.; Kwak, Y.; Kim,
M.; Lee, J.K.; et al. Regioisomeric Effects Regulating the Physicochemical Properties of Complex Copolymers in Thin Films. Eur. Polym. J. 2025,234, 114032.
Hansen, C. M. Hansen Solubility Parameters: A User’s Handbook; CRC Press, 2007.
Park, J.; Lee, S.-G.; Vesters, Y.; Severi, J.; Kim, M.; De Simone, D.; Oh, H.-K.; Hur, S.-M. Molecular Modeling of EUV Photoresist Revealing the Ef-fect of Chain Conformation on Line-Edge Roughness Formation. Polymers 2019, 11, 1923.
Kim, T.-Y.; Kang, I.-H.; Park, J.; Kim, M.; Oh, H.-K.; Hur, S.-M. Coarse-
Grained Modeling of EUV Patterning Process Reflecting Photochemical Reactions and Chain Conformations. Polymers 2023, 15, 1988.
Kim, J.; Kim, S.; Choi, S. K.; Yang, S.; Kim, M. Regulating Cationic Poly-merization of Difunctional Epoxy Resin through Structural Variations of the Thermal Initiator. ACS Appl. Polym. Mater. 2024, 6, 6689.
Deng, J.; Bailey, S.; Jiang, S.; Ober, C. K. High-Performance Chain Scis-sionable Resists for Extreme Ultraviolet Lithography: Discovery of the Photoacid Generator Structure and Mechanism. Chem. Mater. 2022, 34, 6170.
Eun, K.; Yoon, S.; Lee, C.; Kim, G.; Yang, J.; Jung, B. J.; Lee, J.-K.; Kim, M.
Embodiment of Light-Mediated Main-Chain Scissionable Functionality While Preserving the Structure of Conventional Photoimaging Copoly-mer. Adv. Funct. Mater. 2025, 35, 2419243.
Park, K.-W.; Choi, S.; Choi, Y. M.; Kim, G.; Ku, Y.; Son, J.; Lee, J.-K.; Jung, B.
J.; Kim, M. Photoinduced Solubility Modulation in the Copolymers of Fluoroalkyl, Spiropyranyl, and Isobornyl Methacrylates. ACS Appl. Polym. Mater. 2023, 5, 3447.

윤상민 Sangmin Yoon
• 인하대학교 화학과, 학사(2018.3-2024.2)
• 인하대학교 화학·화학공학융합학과, 석사과정(2024.3-현재, 지도교수: 김명웅)

박주영 Juyoung Park
• 인하대학교 화학과, 학사(2018.3-2024.2)
• 인하대학교 화학·화학공학융합학과, 석사과정(2024.3-현재, 지도교수: 김명웅)

이다혜 Dahye Lee
• 인하대학교 화학과, 학사(2019.3-2024.2)
• 인하대학교 화학·화학공학융합학과, 석사과정(2024.3-현재, 지도교수: 김명웅)

도수희 Suhee Do
• 군산대학교 화학과, 학사(2019.3-2023.2)
• 인하대학교 화학·화학공학융합학과, 석사과정(2024.9-현재, 지도교수: 김명웅)

김명웅 Myungwoong Kim
• 한양대학교 화학과, 학사(1998.3- 2002.2)
• 한양대학교 화학과, 석사(2002.3- 2004.2, 지도교수 : 손대원)
• 금호석유화학 전자화학연구소, 연구원(2004.1– 2007.10)
• University of Wisconsin-Madison, 재료공학과, 박사(2008.9- 2013.12 지도교수 : Padma Gopalan)
• Cornell University, 재료공학과, 박사후 연구원(2013.11-2015.1 지도교수 : Christopher K. Ober)
• 인하대학교 화학과, 교수(2015.3-현재)





댓글